近来,芯片行业涌现出一个值得加以留意的变动,众多科技巨头纷纷把目光转向英特尔一项名为EMIB的封装技术,这有可能会使台积电在先进封装领域的垄断态势有所变更。
为什么企业寻找新封装方案
市场当下对于先进封装的需求呈现出急剧增长的态势,特别是在人工智能芯片爆发的伴随情况下。台积电所拥有的CoWoS技术就算处于领先地位,然而其产能扩张的速度却难以跟得上需求的脚步。众多公司察觉到,哪怕芯片已经设计完成,也因拿不到充足的封装产能,从而没办法按时进行生产。
企业因这种供应瓶颈而必须去寻找替代方案,英特尔在先进封装领域多年来持续投入,其EMIB技术已相对成熟,该技术能提供一种可行的备选路径,这不仅是技术路线的选择,还是为保障产品能顺利上市而制定的商业策略。
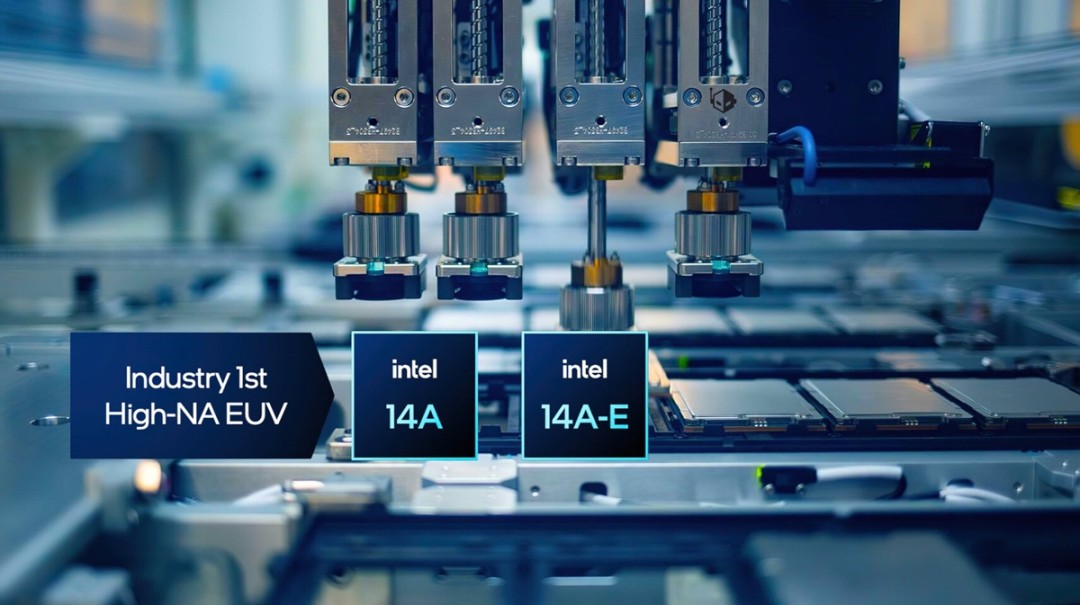
巨头们的具体动向与布局
按照近期所公布出来的公开信息以及招聘方面呈现的动态情况,行动者所列出的名单是相当引为瞩目的。谷歌、Meta等这样的互联网公司当下正在对相关技术展开评估,目的是要为自家所定制的AI芯片寻觅到后续的出路。芯片设计方面的公司美满电子以及联发科同样也展现出了十分浓厚的兴趣。
来自招聘市场的信号更为直接。苹果放出了职位,高通同样放出了职位,明确要求候选人具备英特尔的 EMIB 封装技术经验。这表明相关评估已然进入实质性阶段,企业正在组建团队,为有可能的技术切换做好准备。
苹果与英特尔的深度合作评估
苹果是最为关键的被观察对象,报道表明,苹果正在对英特尔的流程展开全面评估,思索运用EMIB封装其与博通共同设计的AI芯片,这款芯片原本计划采用台积电CoWoS封装,不过因产能存在相关问题而重新予以考量。
存在一种传闻表明,苹果最快会于2027年,运用英特尔的Intel 18A – P工艺从事部分低端M系列芯片的生产,这些芯片会被用于诸如MacBook Air等产品,双方的合作或许远远不只是局限于封装,并且双方已经签署了保密协议,此刻苹果正在等待英特尔去交付更为完整的工艺设计工具包。
EMIB技术的特点与潜在优势
英特尔有着这样一种名为EMIB的技术,它属于2.5D封装技术范畴,此技术运用小型硅桥去连接芯片内部的不一样的模块哩。和那种需要大型硅中介层的CoWoS技术相互比较而言,EMIB所具备的设计显得更为灵活,从理论方面来讲成本或许也是更低的哟。
英特尔自身多代产品验证了该技术,比如在一些高性能服务器CPU中有应用,对于需要把计算核心、高带宽内存等不同模块集成一块的大型芯片,EMIB提供了一个经生产检验的解决方案。
分散供应链风险的战略考量
在此趋势的背后,存在芯片设司对于供链安全的普遍忧虑,把制造以及封装全都集中于一家供应商,虽说协调较为便利,然而抗风险的能力却很薄弱,一旦这家供应商出现产能、出现技术或者出现地缘政治方面的问题,那么整个产品线均会遭受冲击。
所以,那种“前端投片于台积电,后端封装英特尔”的全新模式,实际上是把鸡蛋放置于不一样的篮子当中,这不但能够减轻产能方面的压力,而且能在商业谈判里增添筹码,以此保证更为稳定可靠的供应源头。
对行业竞争格局的长期影响
倘若有更多的公司选用英特尔所提供的封装服务之时,便将会对数以十计的半导体制造业的竞争格局予以重新塑造,台积电会面临封装订单出现流失现象所引发的压力,此项压力极有可能迫使台积电急速加快产能建设的进程或者对定价策略做出相应的调整,而针对于英特尔来讲,它的代工服务也就是IFS将会获取到一个具备强大力量的切入点以及诸多客户案例 。
与此同时,诸如英伟达以及 AMD 这般的巨头,也在对英特尔的 Intel 14A 等先进制造工艺展开评估。这便预示着,在未来,芯片巨头们有可能会采取一种“以台积电为主,以英特尔为辅”的多元代工策略,进而使得行业朝着从单一寡头朝着多强并立的局面进行演变。
倘若你觉得这般“制造跟封装相分离”的模式,会变成往后高性能芯片制造的标准做法吗,欢迎于评论区去分享你的看法。

